접착 촉진제
리드프레임을 위한, IC 패키지 박리를 방지하여 신뢰성을 높이는 제품
구리 합금 표면용 MoldPrep
각 몰드 유형에 대한 업계 표준입니다. 입자간 에칭을 통해 구리 표면을 조면화 처리하고 몰드와 구리 접착력을 대폭 향상합니다.
은 표면용 AgPrep
비에칭 접착 촉진제(NEAP)입니다. 내열성이 뛰어나며 지속 가능한 친환경 기술입니다. 비용 효율적입니다.
사전 도금 니켈(Ni)-팔라듐(Pd)-금(Au) 표면용 ppfPrep
비에칭 접착 촉진제(NEAP)입니다. 지속 가능한 친환경 기술입니다. 기존의 다른 기술(조도가 높은 PPF)에 비해 비율 효율적입니다.
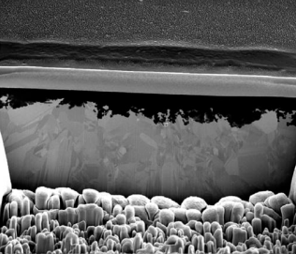
Moldprep 처리 후 구리 리드프레임 표면의 에칭 프로파일
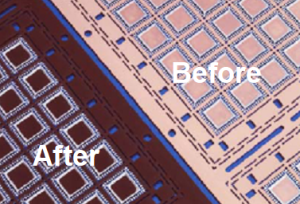
Moldprep 처리 전후의 표면 외관
Moldprep HMC – 구리 합금용 접착 촉진제
아토텍의 Moldprep HMC는 구리 표면 리드프레임을 위한 업계에서 입증된 접착 촉진제입니다. Moldprep HMC는 패키지의 수분 민감도를 1단계 상승시키고 전반적인 온도 안정성을 크게 개선합니다. Moldprep HMC는 구리 합금의 에칭 깊이가 약 0.8~1.6µm인 특수 조면화 처리된 표면을 조성합니다. 그 결과 모든 관련 몰드 화합물과 구리 표면 사이의 접착력을 높이는 유기 금속 흡착 레이어가 생성됩니다. Moldprep HMC는 표면에 오염물이 없도록 하고 수명을 연장시키는 특수 첨가제를 포함합니다.
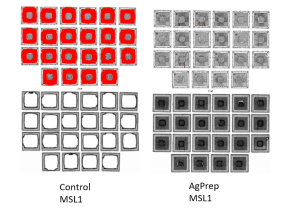
48개의 리드가 포함된 QFN 7×7에서 MSL1 테스트 후의 음향 현미경 사진
AgPrep – 은 표면용 접착 촉진제
이 제품은 업계에서 입증된 비에칭 접착 촉진제(NEAP)로, 은 도금 리드프레임용으로 특수 설계되었습니다. 은 표면은 주로 와이어 본딩 성능을 향상시키는 데 사용되지만 몰드 화합물에 대한 접착력은 좋지 않습니다. 아토텍의 고유한 AgPrep 공정은 은 표면과 모든 관련 몰드 화합물 사이에 화학적 본딩을 생성하며, 이는 보통 전단력 테스트에서 접착력을 두 배로 증가시킵니다. 따라서 수분 민감도 테스트 중의 패키지 신뢰성을 크게 향상하고 극심한 열에 노출되는 MSL1 수준에서도 패키지가 버틸 수 있습니다. 지속 가능한 약품을 기반으로 하는 이 공정은 에칭 공정이 필요하지 않고 비용이 많이 드는 폐기물 처리를 피할 수 있어 비용 효율적입니다.
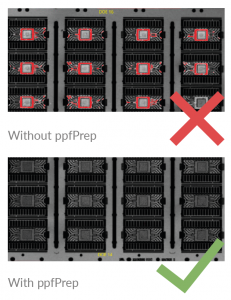
성형 리드프레임의 음향 현미경 사진
ppfPrep – ppfPrep – 니켈-팔라듐-금 표면용 접착 촉진제
이 비에칭 접착 촉진제(NEAP)는 사전 도금 리드프레임의 요구사항을 충족하도록 특수 설계되었습니다. ppfPrep은 NiPdAu 표면과 모든 관련 몰드 화합물 사이에 화학적 본딩을 형성하여 전체 패키지의 신뢰성을 높입니다. 수분 민감도 테스트 및 열 노출 시의 패키지 신뢰성을 크게 향상합니다. 지속 가능한 약품을 기반으로 하므로 기존 도금 라인에 쉽게 통합할 수 있고 IC 조립 공장에도 설치할 수 있습니다. 에칭 공정이 필요하지 않고 비용이 많이 드는 폐기물 처리를 피할 수 있어 비용 효율적입니다.
영감의 원천
접착 촉진제를 개발한 이유
고객의 과제
특히 자동차 산업의 신뢰성 요건은 점점 더 까다로워지고 있습니다. 많은 리드프레임 기반 패키지의 경우 MSL1(습도 민감도 수준)을 뛰어넘어 고온 저장 장치를 더 추가합니다. 이로 인해 종종 IC 패키지를 봉공 처리해야 하는 몰드와 금속 표면 사이에 박리 문제가 발생합니다. 이러한 박리 스팟은 전체 패키지의 신뢰성을 저하시키는 부식 현상의 시작점이 됩니다. 따라서 접착 촉진제는 와이어 본딩, 다이 부착 등과 같은 관련 공정에 악영향을 미치지 않으면서 이러한 여러 문제를 안정적으로 극복할 수 있어야 합니다.
아토텍의 솔루션
아토텍은 주로 리드프레임에 사용되는 세 가지 표면에 대한 맞춤형 솔루션을 제공하여 가능한 한 최상의 솔루션을 보장합니다. 구리의 경우, 유기 금속 흡착 레이어를 생성하는 특별한 조면화 공정을 기반으로 수명이 긴 공정을 개발했습니다. 값비싼 은과 니켈(Ni)-팔라듐(Pd)-금(Au) 표면의 경우 아예 다른 방향을 택해, 몰드와 표면 사이에 실제 화학적 본딩을 구축하는 고유한 비에칭 접착 촉진제를 만들었습니다. 이를 통해 값비싼 금속을 절약할 뿐만 아니라 전반적인 접착력을 크게 높이고 IC 패키지의 신뢰성을 독보적으로 향상할 수 있습니다.
문의하기

