表面处理
为封装载板和印制线路板(HDI/MLB和柔性/刚柔板)的集成湿化学工艺和设备解决方案
要闻速览
- I/L键合的全球市场领先者
- 专门的铜前处理解决方案
- 先进的粘合促进剂和蚀刻剂
- 去除干膜和湿膜,优化精细线路生产
应用
- 增强键合
- 先进表面前处理
- 去除干膜和湿膜
- 印制线路板和封装载板应用
产品组合
增强键合
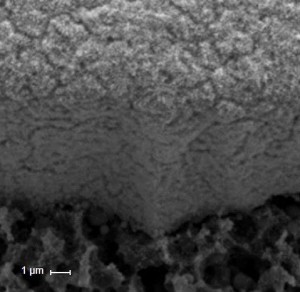
Nano-structure formed byNovaBond® IT
- NovaBond® IT: 非蚀刻性粘合促进剂,可促进IC载板和高频材料的可靠的机械粘合。NovaBond 工艺还提供良好的热可靠性,并与阻焊材料相容。非蚀刻性质使其具有显着的信号完整性优势,特别是在高频应用中。
- Multibond®: 这一黑色氧化物工艺可在宽阔的温度和停机时间范围内运作,在不同的应用中产生各种键合特性。
- BondFilm®: 安美特的简单而经济的氧化物替代工艺,可改进内层键合。安美特在全世界安装了400多条生产线和设备,领导着该领域的全球市场,促进了许多关键印制线路板制造商的成功。
先进表面预处理
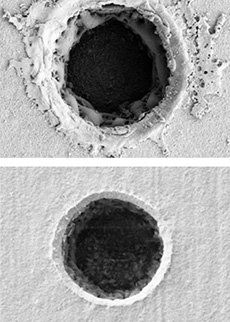
Excellent copper splash removal using BondFilm® LDD SR
- EcoFlash®: 一个只有一个步骤的创新差分蚀刻工艺, 可应用于使用SAP和MSAP技术的细线制作。
- CupraEtch® DT: 特别开发的干膜前处理工艺, 提供出色的表面粗糙度
- CupraEtch® SR: 流程简单的阻焊油墨前处理工艺。如CupraEtch工艺一样有高铜负载量, 减少产生废水, 从而可减低运作成本。
- BondFilm® LDD: 可靠的 BondFilm® 系列 已进一步开发至 BondFilm LDD 产品。它提供能 吸收最多二氧化碳激光量的前处理表面, 因此能确保改善直接激光钻孔表现。同时,比起其他直接激光钻孔前处理工艺能提供大小一致的孔和有效地降低了“铜溅” 和“ 侧蚀“ 。
- ResistAssist 20: 先进的表面前处理系统,专门针对应用于超细线路的生产。
干膜和湿膜剥离

Superior performance of ResistStrip IC for very fine lines
- ResistStrip® 系列: 应用广泛的 ResistStrip® 系列产品可确保Atotech能够为每一种PCB应用的需求提供合适的解决方案。该产品系列主要是氢氧化物和有机胺两种体系, 它们能增强剥膜性能同时减少金属溶解。
- ResistStrip® IC 系列: ResistStrip® IC 系列是应用于高要求的IC 载板的细线路生产而设计的工艺。改良了传统的脱膜机理, 减少夹膜的问题及有效防止细线路间的干膜残留, 所以非常适合用于 先进制程,如SAP。
金属镀层剥离
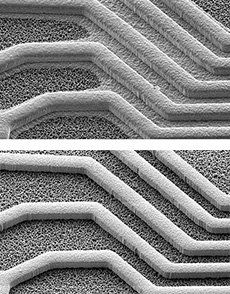
Top: final result without PallaStrip® IC, bottom: final result with PallaStrip® IC
- PallaStrip® IC 2: 不含氰化物的脱钯剂,适合除去基材表面的钯种籽层。在细线应用中, 去除任何钯种籽层都是至关重要, 因为它们可以引致后续的电镀工序有不受控的沉积。PallaStrip是一个不使用任何有害氰化物, 而且简单和容易的工艺。
- TinSolv® & SolderStrip®: 安美特 两步骤和单一步骤的金属脱剂, 能确保铜表面在金属剥离后清洁和被活化。TinSolv®的配方(去除锡)和SolderStrip®(去除锡/铅), 无论在表面以及在小孔和盲孔 都有完整和均匀的 去除 。
在模压树脂上直接金属沉积

Singulated chips after Ni plating for conformal EMI shielding
- 在模压树脂上直接进行金属沉积的技术: Booster® 是一种独特的湿化学粘合增强工艺,用于直接在模压树脂上进行无底漆金属电镀。在模压树脂上直接电镀的方法可应用于模压树脂上的共形电磁干扰(EMI)屏蔽和“直接电路形成”,例如用于FO WLP(FO PoP、FO SiP)。Booster® MR工艺可以处理单个和带状产品,通过输送用胶带防止I/O侧受到电镀溶液的侵蚀。
用于玻璃电镀的结合力促进剂
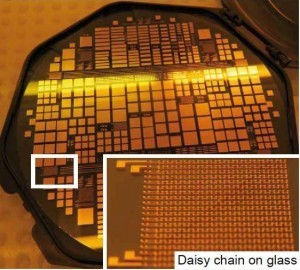
Cu patterning on glass wafer with VitroCoat GI
- 用于玻璃电镀的附着力促进剂: Atotech的VitroCoat GI是一种创新的结合力促进剂,可通过湿化学方法在玻璃上形成金属沉积。工艺采用简短而有成本效益的浸涂方法进行处理。相对其他竞争流程如金属喷镀,VitroCoat GI的最大优点是有利在非对等附着性的表面 , 于高纵横比的镀通孔上有良好的覆盖能力。
特色产品
Horizon® BondFilm
用于增强键合和表面处理技术的综合生产解决方案。
The Horizon® BondFilm 系统提供了安美特在化学处理、薄材料输送以及液体输送方面的最新技术方案。
- Horizon® BondFilm LDD ——提供能 吸收最多二氧化碳激光量的前处理表面, 因此能确保改善激光钻孔表现。
- CupraEtch® ——独特的多用途微蚀刻系统,可在高质量印刷电路板生产中实现主要成像抗蚀剂或阻焊油墨的最佳结合力
您知道吗?
对于高频键合系统,我们的解决方案可提供最佳的热可靠性和最小的表面粗糙度,确保5G应用中最低的信号损失。
最新出版物
用于IC载板封装的高级结合力促进剂系统
本文重点介绍了低蚀刻处理工艺的发展,该工艺可应对增强性能和最低信号插入损失的挑战,适用于5G应用。EXPT NovaBond EX是专为应对这些挑战而开发的系统,可形成光滑的铜表面,确保 最小咬铜量(< 200纳米),之后用结合力促进剂处理铜面,以提供最高的结合力强度。
2019, PDF, 240 KB
新型先进阻焊油墨和 干膜和湿膜 前处理方法可提供显着的废水优势和较低的咬蚀深度
安美特开发了一种新的基于硫酸铁的微蚀刻工艺,在技术上和商业上都优于现有的用于阻焊油墨和 干膜和湿膜 的POR前处理化学品。
该工艺的重要优势是超低咬蚀深度的出色结合力以及极高的铜负载,这使得该工艺在镀液带出范围内具有低流失,从而显着减少废水量。
2017, PDF, 1,000 KB
VitroCoat GI ——采用氧化金属层和湿化学镀铜在玻璃上形成精细图形线路, 在玻璃上进行电镀
随着微型化和异构集成的发展趋势,IC和先进基板制造商致力于满足下一代平台的需求,增加互连密度,制造具有更精细线路和空间的导体。
为了满足这些要求,人们设计、实现并实施了半加成工艺(SAP)和高级改良型半加成工艺(amSAP)等先进制造技术。先进载板的铜导线的线路和空间(L/S)要求低于5/5微米,在不久的将来芯片到芯片连接需要2/2微米的L/S。
本文阐述了新开发的面向SAP和amSAP应用的基于硫酸铁的EcoFlash®工艺的性能,重点是以玻璃为基材,以VitroCoat®作为薄金属氧化物结合力促进层。
我们成功地将结合力促进层以及化学镀铜和电解铜镀技术运用到半加成工艺和晶种层蚀刻中,能够产生小于10微米的L/S。
2019, PDF, 1,020 KB