半导体
面向先进封装和半导体,整合了湿法工艺化学品和设备解决方案
要闻速览
- 铜、镍、钯、锡、银锡和金等化学镀和电镀的先进封装解决方案
- 最新互连技术的电化学解决方案——大马士革铜和钴
- MultiPlate:创新的电镀机台
- 高科技洁净室生产
应用
- 应用于功率芯片和存储器焊盘金属化的化学镀镍钯金技术
- 应用于FOWLP和FC-CSP的RDL、微孔和铜柱电镀
- 应用于传感器和3D堆叠的微孔和硅通孔电镀
- 应用于功率芯片的双面金属化,例如IGBT、MOSFET等
- 应用于逻辑电路、存储器、功率芯片的互连技术
产品组合
FOWLP和FC-CSP的RDL、微孔和铜柱电镀
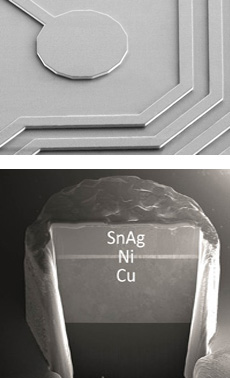
您的挑战:
FOWLP等最新封装技术需要为不同结构提供各种电镀解决方案。如带及不带微孔填充的RDL细线路,带和不带镍阻挡层的铜柱,以及锡银焊帽的铜柱。最重要的是铜镀层的纯度藉以提高整体可靠性。铜镀层的纯度决定了整个封装的可靠性,可避免FOWLP中RDL断裂以及铜/焊料界面处的微孔洞。
我们的解决方案:
安美特提供完整的铜柱、微孔和细线路RDL最高纯度铜沉积方案,无论是RDL、微孔还是铜柱,均可满足最严苛的可靠性要求。适用于所有电镀铜方案。我们的铜电镀液可镀所有结构:微孔、细线路RDL和铜柱。
我们的产品:
- Spherolyte Cu UF3: 高纯性能适用于所有的铜结构:RDL、微孔和铜柱
- Spherolyte Ni: 在焊料与铜之间作为有效的阻挡层,以避免空洞
- Spherolyte SnAg: 我们的最新产品,含有2%的银确保可靠的互连
功率芯片的双面电镀,例如IGBT、MOSFET等

您的挑战:
新型的IGBT和高功率MOSFET需要在晶圆两面进行金属化。在标准工艺流程中,首先电镀晶圆正面,然后再电镀背面,这样经常会产生应力和翘曲问题。特别是减薄片,当需要嵌入功率芯片到封装中,很容易产生这种问题。在晶圆处理中,我们需要有效减少应力和翘曲。
我们的解决方案:
我们提供一种替代工艺——正反两面同步镀铜,有效地减小应力和翘曲,并有如下优势:
- 正反面单独控制铜层厚度
- 可电镀Taiko wafer
- 减少工艺流程
- 设备和化学品一站式服务
我们的产品:
MultiPlate® 和 Spherolyte® MD2: 是我们功率芯片的最佳阵容
焊盘金属化和RDL外层保护
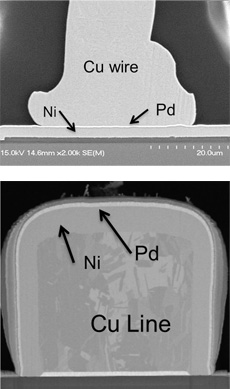
您的挑战:
引线键合和焊接——哪种表面处理是您最合适的封装解决方案?如何在铝合金晶圆或铜晶圆上获得所需的金属叠层?这已经是大量产了吗?该方法是否可靠、是否通过车载或者更恶劣的环境验证?所有这些都是典型的问题和挑战,最终决定了应该电镀什么金属作为第一级互连。
我们的解决方案:
- 通用型前处理方法,例如可应用于所有铝合金表面的沉锌,以及应用于铜晶圆的通用型活化方法
- 经过汽车业验证的化学镀镍 – 化学镀钯 – 浸金叠加
- 产能极高的湿法工艺,一次看可作业25或50片晶圆
- 不含氰化物的工艺
- 耐高温的三元镍合金
- 纯钯镀层提高可靠性
我们的产品:
- Xenolyte Pd HS: 纯钯,提高引线键合性能
- Xenolyte Ni TR: 三元镍合金,耐高温
- Xenolyte Au CF2: 不含氰化物的浸金工艺
应用于逻辑电路、存储器和功率芯片的互连金属化解决方案
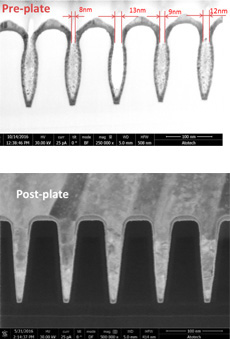
您的挑战:
下一代互连技术需要极高性能的湿法金属化工艺
- 兼容极薄籽晶层,应用于后道大马士革铜互连
- 能够填充先进制程的预镀开口,进行铜和钴互连
- 无空洞,高纯度铜和钴
最重要的是无空洞互连填充。互连越来越密集、复杂程度越来越高,但良率要求比以往更高。
我们的解决方案:
- 安美特提供最先进技术的铜和钴互连的湿式金属化化学品
- 我们提供每一步金属化的药液,并兼容所有最新技术电镀机台
我们的产品:
- Everplate 2XT: 高性能添加剂系统,能够填充先进的大马士革铜技术节点
- Atomplate Co: 应用于中道互连技术的电镀纯钴,能够实现真正自下而上的填充
特色产品

高纯度化学品生产
半导体工业的洁净室生产
我们根据最新和最严格的半导体行业要求生产高纯度化学品。我们位于德国新鲁平的1500平方米洁净室生产设施配备了高度自动化的生产设备和封闭的生产环境,可确保高效、安全、环保和高成本效益的生产。
视频
MultiPlate®
一款面向下一世代封装技术的创新型电镀设备
![]()
您知道吗?
除MultiPlate®外,我们还拥有在电镀领域提供一站式服务的独特地位,可为电镀封装提供高纯度化学品、电镀设备和工艺开发。
最新出版物
一款面向下一世代封装技术的创新型电镀设备
本文首次发表在“Silicon Semiconductor”上。
随着器件尺寸不断缩小,半导体封装技术面临着是否仍然适用和具有经济效益的持续挑战。当前需要是开发能够经济有效解决新兴需求的创新方法。本文通过重新思考传统制造方法,探讨当前先进封装正面临的挑战以及如何予以克服。
2016, PDF, 3,400 KB
扇出型封装:在移动设备中实现最佳性能的关键推动因素
本文首次发表在“Chip Scale Review”上。
FOWLP的出现是为了满足消费电子产品,特别是移动设备的要求。本文探讨扇出型封装背后的驱动因素、关键的工艺难题以及应用层面上的要求。文章还讨论了为什么扇出是下一代移动设备的理想封装技术,并展示了以在晶圆和面板方面进行生产的整体解决方案。
2017, PDF, 1,200 KB
新一代铜柱电镀技术
本文首次发表在“Chip Scale Review”上。
随着整个行业朝着更小、更快设备的方向发展,所有供应链成员都面临着以更低成本实现更高性能的压力越来越大。
摩尔定律的局限性已被证明,先进的技术节点不再具有显着的成本效益。因此,业界已将重点转向先进封装,将其作为实现提高性能和降低成本的手段,即“超越摩尔定律”。
这种转变的主要驱动因素是提高性能、增加功能性和降低成本。本文讨论了这三种驱动因素如何促使应用用铜柱的倒装芯片封装的出现以及铜柱技术当前和未来面临的挑战。
2016, PDF, 560 KB
锡银铜焊料与镍(磷)/金、镍(磷)/钯/金之间的相互作用
本文研究了Sn3.5Ag0.5Cu焊料与镍(磷)/金、镍(磷)/钯/金两种不同的UBM结构之间的金属间化合物的相互作用。
2015, PDF, 2,250 KB