电镀
面向封装载板和印制线路板(HDI/MLB和子柔性/刚柔板)的综合湿化学工艺和设备解决方案
要闻速览
- 提供最高可靠性和生产力的电镀铜液
- 应用于不同设备的电镀铜液: Uniplate® IP2, 垂直连续电镀系统, 传统龙门线
- 应用于水平传送系统生产的市场领先Uniplate® IP2
应用
- 一般通、微盲孔电铜
- 微盲孔填充
- 通孔填充
- 前处理
- 抗蚀刻金属镀层, 最终表面电镀
产品组合
通、盲孔电铜工艺

Panel 2.4 mm thickness incl. flash copper, hole diameter 0.2 mm, aspect ratio: 12:1, throwing power: > 85%
- 使用 Uniplate® InPulse 2 设备进行高产量通盲孔电镀: Inpulse® 2HFU具有出色的微盲孔深镀能力,可弥补钻孔瑕疵,可靠覆盖楔形空洞。该工艺是进行可靠mSAP闪镀的理想解决方案。Inpulse®2HT可确保最佳的通孔电镀均匀性,显着改进较高和较低孔密度区域之间的表面镀铜分布。
- 安美特的 Cupracid® TP 系列的最新产品: Cupracid® TP3. 这是一项用于传统龙门线采用可溶性阳极直流设备的电铜工艺。它可在高电流密度和低表面张力的条件下,可全面润湿微盲孔和通孔, 确保出色的深镀能力。Cupracid® TP3提供出色的可靠性结果。这是一项非常简单方便的工艺,在停机后也具有稳定的电镀性能。
- Cupracid® AC 应用于可溶性阳极的电镀铜工艺。在高电流 密度应用下, 微盲孔 和通孔有卓越的深镀能力。Cupracid® AC可应用于大部份的垂直连续电镀线设备, 以及喷流式或空气搅拌。
- 用于可溶性阳极系统的 Cuprapulse® XP7 是我们的脉冲电镀解决方案,可实现高以8横比的通盲孔镀铜。Cuprapulse® XP7的深镀能力是直流技术远远无法达到的。高电流密度脉冲电镀可提高生产力, 同时改进质量,例如有更好的表面分布和线形。
微盲孔镀铜填充
- 水平微盲孔填充: Inpulse® 2HF 具有出色的微盲孔填充性能(Superfilling®)。可实现最大的微盲孔填充效果以及最小的表面镀铜。将独特的Uniplate® InPulse 2系统的Inpulse® 2HF与安美特 Fe-redox铜补充系统结合起来,非常适合用于高端高容量HDI的生产,并已经过实践验证。安美特的最新研发产品Inpulse® 3MSAP与新的Uniplate® InPulse 3设备结合使用,可确保微盲孔的图形填充以及出色的面板表面分布。该工艺专门用于高电流密度条件下的(a)mSAP生产,可提供出色的矩形线路形状。
- 垂直微盲孔填充: InPro® MVF and InPro® MVF2 是目前和下一代HDI微盲孔填充的VCP制程。它们专门用于垂直连续电镀线设备, 在直流电铜模式下采用不溶性阳极,可实现出色的微盲孔图形填充,避免凸起,确保最小镀层厚度。我们的InPro® THF经量产验证,不仅适合通孔填充,而且可在VCP系统中采用不溶性阳极, 及在高电流密度下微盲孔图形填充的制程, 更是mSAP应用的参照方法。其后续产品InPro® THF2具有更好的填充能力、更高的均匀度,特别在amSAP生产中有高延展性能。
通孔镀铜填充

Laser drilled , inclusion-free through hole: Diameter 100 µm, panel thickness 0.2mm, plated Cu 15 µm
- Inpulse® 2THF 配合独特的Uniplate® InPulse 2水平反向脉冲电镀系统, 是非常适合通孔填充,特别是对于具有小于5μm厚度的铜箔的材料. Inpulse® 2THF将获得专利的X电镀和Superfilling®技术结合在一个工艺化学品中,在最少面铜厚度逵至可靠及无空洞填充。
- InPro® THF 是应用在IC载板上填充以激光钻方式的通孔(LTH)的 垂直连续电镀系统。该工艺在全球VCP设备中进行批量生产。其后续产品InPro THF2可提供更好的填充性能和均匀度。两种产品均可用于(a)mSAP生产中在最高电流密度条件下的微盲孔图形填充。
最终表面的电镀层

SolderFill for filling of smallest SRO’s
- Nikotron®: 柔软,延展性好和内应力低的镀镍层; 可控的应力和硬度
- Aurotron®: 应用于引线接合,以及硬金应用焊接的电金工艺
- Pallatron: 更高可靠性的电钯工艺和为镍/钯/金应用降低成本
- SolderFill®: 高速电锡 电镀能克服锡膏印刷和微球落点的的限制
- StannoBond®: 在铜柱上焊接 和热压接应用的电镀锡工艺
导线重新分布层 (RDL)、铜柱(Pillar)电镀
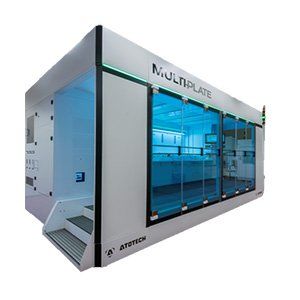
- 新的 Innolyte® 电镀产品系列结合了创新电镀设备技术MultiPlate®。高纯度Innolyte®化学品专门用于在最高电流密度下进行RDL结构和铜柱电镀,可实现出色的镀层均匀度。镀铜采用高纯铜,确保最高的铜特性和可靠性。
前处理
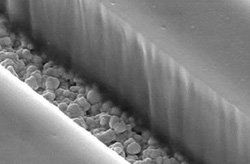
Cleaning for 3 min at 35 °C: no attack and no dry film lift off
- CupraPro® S8: 可生物降解的前处理工艺, 应用于所有HDI板和图形电镀铜板, 它提供优异的清洗能力 和低表面张力, 所以 能提供最佳润湿性, 同时 降低带出量。
- CupraPro® MV: 应用于IC 载板的可生物降解前处理工艺, 专门为垂直龙门设备而设计的。它不含NPE, 低动态表面张力为微孔填充 提供 快速又有效的前处理, 同时降低带出量。
- CupraPro® VC: 应用于所有板面和图形镀铜的新酸性前处理产品, 特别设计用于垂直连续电镀线设备。它在紊流环境下也是低泡性, 为所有结构的基材特别是高纵横比的通孔和BMV提供快速又有效的润湿 。
特色产品

InPro® THF / InPro® THF2
Panel/pattern via filling in VCP using insoluble anodes for (a)mSAP
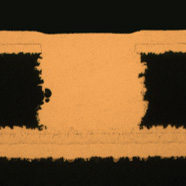
InPro® MVF / InPro® MVF2
Excellent filling results for next gen. HDI, flex and Automotive production
Uniplate® InPulse 2
安美特领先的综合沉铜水平系统
独特的Uniplate® InPulse 2系统和工艺能够满足在高电流密度和不溶性阳极条件下使用脉冲电镀进行高端生产的所有要求。
- Inpulse® 2HF ——安美特的SuperFilling技术可实现可靠的叠孔技术高产量HDI生产
- Inpulse® 2MSAP ——安美特的第一个用于(a)mSAP生产的水平图形微盲孔填充工艺
- Inpulse® 2THF ——独特的无空洞通孔填充工艺,确保最小的表面镀铜
- Inpulse® 2HFU ——最佳微盲孔工艺,以便后续进行mSAP生产中的加层和铜填充
您知道吗?
安美特不仅为我们提供独特的Uniplate® IP2系统,也为VCP和龙门线系统提供铜填充解决方案。通过板/图形电镀中的低表面镀铜进行微盲孔填充。我们为水平设备提供无空洞的通孔填充以及为垂直连续电镀系统提供图形电镀。
最新出版物
电解镀铜填充微孔和通孔——现状与展望
2019, PDF, 540 KB
提高FOPLP(扇出型面板级封装)应用中镀铜的面板大小可降低制造成本
人们对高性能、低成本以及智能手机这类纤薄终端用户设备的要求在不断增长,这就需要在包括载板和芯片封装在内的所有电子组件设计领域中进行深入的开发和创新。扇出型晶圆级封装和先进载板两个领域不断涌现出新兴制造技术,很有希望成为满足这些要求的关键部分。本文介绍了电镀工艺关键性能领域的最新研究和结论,如电解液动力学、阳极设计的影响、脉冲反向整流以及新设计的用于最大600毫米面板的电解液。
文章首次在2018年美国帕萨迪纳iMAPS上发布。
2018, PDF, 900 KB
利用新型铜电解液进行半加成电镀可提高IC载板生产率
文章首次在2018年新加坡EPTC上发布。
2018, PDF, 320 KB
应用于新世代封装技术 , 在VCP系统上填充 幼细线路的通孔
文章首次在2017年芝加哥SMTA上发布。
2017, PDF, 510 KB