Elektrolytische Metallabscheidung
Ganzheitliches System von nasschemischer Verfahrens- und Anlagentechnik für Package-Substrate und Leiterplatten
Fakten im Überblick
- Elektrolytische Metallabscheidung für höchste Anforderungen an Zuverlässigkeit und Produktivität
- Lösungen für verschiedene Anlagentypen: Uniplate® IP2, V-Plate® und andere vertikale Durchlaufanlagen (VCP), Vertikal-Gestellanlagen
- Marktführende Uniplate® IP2-Anlagen für horizontale Durchlaufproduktion
Anwendungen
- Gleichmäßige Metallabscheidung
- Füllen von Sacklochbohrungen (BMV)
- Füllen von Durchgangsbohrungen (TH)
- Vorbehandlung
- Metallresist, galvanische Bäder für Endoberflächen
Produktübersicht
Gleichmäßige Kupferabscheidung

Panel 2.4 mm thickness incl. flash copper, hole diameter 0.2 mm, aspect ratio: 12:1, throwing power: > 85%
- Gleichmäßige Metallabscheidung für die Massenproduktion mit Uniplate® InPulse 2-Anlagen: Durch die gute Metallstreuung in Sacklochbohrungen kann mit Inpulse® 2HFU eine zuverlässige Metallisierung selbst bei Bohrungsdefekten und wedge voids erfolgen. Das Verfahren ist bei der mSAP-Technologie die ideale Lösung für zuverlässiges Flash Plating. Inpulse® 2HT gewährleistet selbst in Bereichen hoher und niedriger Bohrlochdichte ein Höchstmaß an Gleichmäßigkeit der Metallisierung in Durchgangsbohrungen und auf der Oberfläche.
- Die neueste Version der Atotech Cupracid® TP Serie: Cupracid® TP5. Hierbei handelt es sich um ein galvanisches Kupferbad für konventionelle Vertikal-Gestellanlagen mit Gleichstrom mit löslichen Anoden. Es bietet eine hervorragende Streufähigkeit in Durchgangsbohrungen und BMVs bei hohen Stromdichten. Darüber hinaus bietet Cupracid® TP5 bietet hervorragende Zuverlässigkeitsergebnisse und eignet sich daher z. B. für die anspruchsvolle Automobilproduktion.
- Cupracid® AC5 ist unser Verfahren der nächsten Generation für die konforme Kupferbeschichtung mit löslichen Anoden. Es bietet gute Streufähigkeit sowohl in BMVs als auch in Durchgangsbohrungen bei hohen Stromdichten. Es ist mit einer breiten Palette von Metallisierungsprozessen auf dem Markt kompatibel und eignet sich ideal für die Automobilproduktion. Cupracid® AC5 ist mit einer Vielzahl von vertikalen Durchlaufanlagen (VCP) mit Elektrolytbewegung durch Eduktoren sowie in Vertikal-Gestellanlagen mit Lufteinblasung einsetzbar.
- Cuprapulse® XP8 für Vertikal-Anlagen mit löslichen Anoden ist der Nachfolger unserer bekannten Reverse Pulse Plating-Lösung Cuprapulse® XP7 für die gleichmäßige Kupferabscheidung bei hohem Aspektverhältnis. Die Gleichstromtechnologie kommt nicht einmal annähernd an die mit Cuprapulse® XP8 erzielte Streufähigkeit heran. Die hohe Stromdichte beim Reverse Pulse Plating ermöglicht eine höhere Produktivität bei gleichzeitiger Qualitätsverbesserung wie bessere Oberflächenverteilung und Leiterbahnform. Cuprapulse® XP8 bietet eine bessere Prozessstabilität, ein größeres Arbeitsfenster und ein verbessertes Oberflächenbild.
- Cuprapulse® IN ist unsere Antwort auf die steigende Marktnachfrage nach vertikalem Reverse Pulse Plating mit unlöslichen Anoden in VCP- und Vertikal-Gestellanlagen. Es bietet ein gleichmäßigeres Kupferaussehen im Vergleich zu Standard-Reverse Pulse Plating-Prozessen mit löslichen Anoden. Es kann bei turbulenten Strömungsbedingungen betrieben werden, ohne daß es zu einem Ausölen oder dem sogenannten „two-tone effect“ kommt. Die Reverse Pulse Plating ermöglicht eine überragende Streufähigkeit bei kürzester Beschichtungszeit für einen hohen Durchsatz in Ihrer Beschichtungsanlage.
- Speziell für die Anforderungen des Flex- und Starrflex-Marktes haben wir InPro® FLEX2 / Cupracid® FLEX2 entwickelt. Beide Verfahren bieten eine gleichmäßige Kupferabscheidung bei hohen Stromdichten und bieten eine hervorragende Streufähigkeit in Durchgangsbohrungen. Die mit beiden Verfahren abgeschiedenen Schichten haben ein ausgezeichnetes Kristallgefüge, eine hohe Duktilität und eine sehr gute Biegefähigkeit, um die höchsten Anforderungen flexibler Leiterplatten zu erfüllen. InPro® FLEX2 ist für die Verwendung mit unlöslichen Anoden vorgesehen, Cupracid® FLEX2 arbeitet mit löslichen Anoden.
Füllen von Sacklochbohrungen (BMV) mit Kupfer
- Füllen von Sacklochbohrungen in Horizontal-Anlagen: Inpulse® 2HF9 bietet ein hervorragendes BMV-Fülllergebnis (Superfilling®). Mit dem Superfilling®-Prozess werden sehr gute Füllergebnisse bei minimaler Kupferabscheidung auf der Oberfläche erzielt. Dadurch eignet sich der Atotech Superfilling®-Prozess, bestehend aus der Uniplate® InPulse 2-Anlage in Kombination mit der Fe-Redox-Kupferergänzung und dem Inpulse® 2HF9-Kupferbad, ideal für die High-End-Massenproduktion von HDI-Leiterplatten und wird bereits vielfach dafür eingesetzt.
- Füllen von Sacklochbohrungen in Vertikal-Anlagen: InPro® MVF und InPro® MVF2 sind Atotech’s Kupferelektrolyte die in VCP-Anlagen zum Füllen von Sacklochbohrungen von aktuellen und zukünftigen HDI-Leiterplattendesigns eingesetzt werden. Beide Kupferbäder sind für den Gebrauch von unlöslichen Anoden mit Gleichstrom konzipiert und haben bei geringer Schichtdicke auf der Oberfläche eine hervorragende Filling-Performance bei Sacklochbohrungen ohne „Dome-Plating“.
- Das in der Massenproduktion bewährte InPro® THF wird in VCP-Anlagen mit unlöslichen Anoden zum Füllen von Durchgangsbohrungen sowie auch zum Füllen von Sacklochbohrungen in Panel oder Pattern Plating bei hohen Stromdichten für mSAP-Anwendungen eingesetzt. Es ist die Referenz für mSAP-Anwendungen. Die nächste Generation InPro® THF2 bietet eine verbesserte Filling-Performance, bessere Oberflächenverteilung und Duktilität, welche besonders wichtig bei der amSAP-Fertigung ist.
- InPro® SAP3 ist unser in der Massenproduktion bewährtes Verfahren für das Füllen von Sacklochbohrungen mit Kupfer bei IC Substraten in vertikalen Durchlaufanlagen (VCP) mit unlöslichen Anoden. Dieser Prozeß ermöglicht eine exzellente Oberflächenverteilung innerhalb eines Fertigungsnutzens, dadurch kann die Produktivität durch höherer Stromdichten erhöht werden. Der Elektrolyt hat ein großes Arbeitsfenster, in dem eine gute Filling-Performance erzielt wird und gewährleistet zuverlässig hohe Fertigungsresultate bei Fine Line-Anwendungen. InPro® SAP6 ist unser Prozeß der nächsten Generation. Er kann mit noch höheren Stromdichten betrieben werden, um die Produktivität zu steigern. InPro® SAP6 bietet im Vergleich zur POR-Chemie die beste Oberflächenverteilung innerhalb eines Fertigungsnutzens auf dem Markt für anspruchsvolle IC-Schichten und eine hervorragendes Oberflächenbild.
- Das Füllen von Sachlochbohrungen bei flexiblen Leiterplatten, speziell wenn RA-Kupferfolien verwendet werden, ist nicht einfach. In diesem Fall ist es schwierig ein gleichmäßig gutes Füllverhalten bei einer gleichzeitig glänzenden Kupferschicht abzuscheiden. Grund dafür ist die typische Kristallstruktur des RA-Kupfers. InPro® FLEXFILL bietet eine glänzende Kupferabscheidung sowie ein zuverlässiges Füllverhalten selbst bei „half etched“ RA-Kupferfolien und erfüllt dadurch die Industriestandards für Zuverlässigkeit von flexiblen Leiterplatten. InPro® FLEXFILL kann sowohl in vertikalen Durchlaufanlagen (VCP), Reel-to-Reel-Durchlaufanlagen sowie in vertikalen Gestellanlagen mit inerten Anoden und Elektrolytbewegung mittels „sparger“ eingesetzt werden.
Füllen von Kupferdurchgangsbohrungen

Laser drilled , inclusion-free through hole: Diameter 100 µm, panel thickness 0.2mm, plated Cu 15 µm
- In der Kombination Uniplate® InPulse 2-Anlage mit Inpulse® 2THF2 ist dieses System hervorragend zum Füllen von Durchgangsbohrungen geeignet, insbesondere für Innenkerne mit weniger als 5 µm Kupferkaschierung. Das System Inpulse® 2THF2 wird mit Reverse-Pulse-Plating betrieben und füllt die Durchgangsbohrungen zuverlässig und ohne Einschlüsse (inclusion-free). Dabei wird unser patentierter X-Plating-Prozess mit dem Superfilling®-Prozess kombiniert, um eine möglichst geringe Schichtdicke auf der Oberfläche abzuscheiden.
- InPro® THF wird weltweit in VCP-Anlagen mit Gleichstrom zum Füllen von lasergebohrten Durchgangsbohrungen (LTH) bei der Massenproduktion von IC-Substraten eingesetzt. InpPro® 2THF2 ist die nächste Elektrolyte-Generation und bietet eine verbesserte Filling-Performance und Oberflächenverteilung. Beide Elektrolyte können auch zum Füllen von BMVs in Pattern Plating mit hohen Stromdichten für die (a)mSAP-Produktion verwendet werden.
Metall-Resist-Beschichtung (Zinn)

- Sulfotech® LST ist unser Metallresist-Verfahren, das eine außergewöhnliche Verteilung der beschichteten Oberfläche aufweist. Der Elektrolyt kann kostengünstig mit Schwefelsäure gefahren werden, es gibt auch eine MSA-Variante. Er scheidet feinkörniges, dichtes Zinn für optimale Ätzbeständigkeit ab. Der Elektrolyt weist eine niedrige Oberflächenspannung auf und erzielt gute Ergebnisse bei BMVs und hohen Aspektverhältnissen. Darüber hinaus entsprechen die Prozessadditive den EU-Umweltvorschriften und sind frei von NPE und Methanol.
- Tinpulse® SC : Ermöglicht eine hohe Produktivität durch Abscheidung im Pulseverfahren (3-4x höher im Vergleich zum Standard-Gleichstromverfahren) für Metallresistanwendungen. Der Prozeß bietet eine hervorragende Streuffähigkeit in BMVs und Durchgangsbohrungen mit hohem Aspektenverhältnis (AR bis zu 20:1) und der Einsatz des Pulseverfahrens verbessert die Kristallstruktur für eine optimale feinkörnige, dichte Zinnabscheidung. Das Pulseverfahren bietet darüber hinaus eine hervorragende Oberflächenverteilung, was zu einer Kostenreduzierung von ca. 30 % beim Anodenmaterial führt und die Gefahr von Kurzschlüssen und sogenanntes „Mushrooming“ verringert.
Galvanische Endoberflächen

SolderFill for filling of smallest SRO’s
- Nikotron®: Weiche, duktile und spannungsarme Nickelschichten. Eigenspannung und Härtegrad sind einstellbar.
- Aurotron®: Galvanische Goldbäder für Drahtbonden und Löten sowie Hartgoldanwendungen.
- Pallatron: Galvanische Palladiumabscheidung für hohe Zuverlässigkeit und reduzierte Prozesskosten bei Ni/Pd/Au-Anwendungen.
- SolderFill®: Prozess für die Highspeed-Abscheidung von Zinn für Löt-Depot-Anwendungen. Dieser Prozess kann eingesetzt werden, wenn der Lötpastendruck und das Platzieren von Micro-balls an ihre Grenzen stossen.
- StannoBond®: Galvanisches Zinnbad für Lötanwendungen auf Copper Pillars und für sogenanntes Thermo Compression Bonding.
RDL- und Pillar-Plating
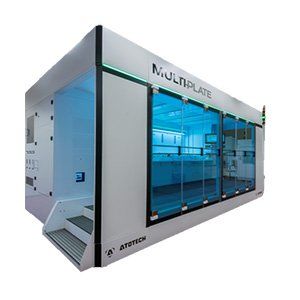
- Die Produktfamilie Innolyte® wurde für MultiPlate®-Anlagen entwickelt. Unsere hochreinen Innolyte®-Chemikalien wurden entwickelt, um RDL-Strukturen und Pillars bei hohen Stromdichten abzuscheiden und dabei eine hervorragende Verteilung der abgeschiedenen Strukturen zu erzielen. Das abgeschiedene Kupfer ist von hochrein, um beste Materialeigenschaften für höchste Zuverlässigkeit zu erzeugen.
Vorbehandlung
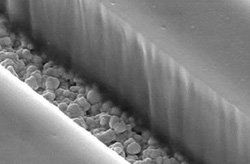
Cleaning for 3 min at 35 °C: no attack and no dry film lift off
- CupraPro® S8: Biologisch abbaubarer Reiniger für HDI Panel- und Pattern-Plating in Vertikal Gestell-Anlagen. CupraPro® S8 hat eine sehr geringe dynamische Oberflächenspannung und erzielt dadurch beste Benetzungs- und Reinigungsergebnisse bei reduzierter Ausschleppung.
- CupraPro® MV: Biologisch abbaubarer Reiniger für Panel- und Pattern-Plating bei der Beschichtung von IC-Substraten, insbesondere in Vertikal Gestell-Anlagen. CupraPro® MV enthält kein NPE und ermöglicht dank seiner geringen dynamischen Oberflächenspannung eine schnelle und effektive Benetzung insbesondere für Via-Filling-Anwendungen bei gleichzeitig reduziertem Drag-Out.
- CupraPro® VC: Ist ein neuer saurer Reiniger für Panel- und Pattern-Plating speziell entwickelt für den Einsatz in Vertikal Durchlaufanlagen (VCP). Der Reiniger zeichnet sich durch eine geringe Schaumbildung selbst bei stark turbulenter Strömung aus und sorgt für eine schnelle und effektive Benetzung insbesondere bei Durchgangs- und Sacklochbohrungen mit hohem Aspektenverhältnis.
High Tech Platingtechnologie von Atotech

InPro® THF / InPro® THF2
Panel/pattern via filling mit unlöslichen Anoden in vertikalen Durchlaufanlagen (VCP) für (a)mSAP Technologie
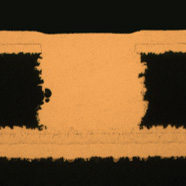
InPro® MVF / InPro® MVF2
Exzellente Fülleigenschaften bei Sacklochbohrungen der nächsten Generation von HDI Schaltungen, Flex und Automobil Anforderungen.

Cupracid® TP5
Kupferelektrolyt mit hoher Streuung Oberfläche / Bohrung für die Produktion von
MLB-, HDI- und Automobilleiterplatten
Cupracid® AC5
Konforme Kupferbeschichtung bei hohen Stromdichten in VCP- und Vertikal-Gestellanlagen
Unsere neue Lösung für konforme Kupferbeschichtung Cupracid® AC5 wurde speziell für den Einsatz in VCPs bei hohen Stromdichten entwickelt. Bei einem Aspektverhältnis von bis zu 12:1 hat es das Potenzial, zum Industriestandard für hohe Streufähigkeit in BMVs und Durchgangsbohrungen zu werden.
Uniplate® InPulse 2
Das führende, ganzheitliche System für die galvanische Kupferabscheidung in Horizontal Durchlaufanlagen
Die Uniplate® InPulse 2-Anlagen und -Prozesse erfüllen alle Anforderungen für die High-End-Produktion von Leiterplatten bei hohen Stromdichten mit Reverse Pulse Plating und unlöslichen Anoden.
- Inpulse® 2HF9 – Atotechs SuperFilling®-Prozess für eine zuverlässige HDI-Massenfertigung mit Stacked-Via-Technologie.
- Inpulse® 2THF2 – einzigartiges Verfahren für einschlußfreies Füllen von Durchgangsbohrung bei minimaler Kupferschichtdicke
- Inpulse® 2HFU2 – optimale Vorbereitung von Sacklochbohrungen für die nachfolgenden Strukturierung und BMV Filling beim mSAP-Produktionsprozeß
vPlate®
Atotechs Lösung für die vertikalen Durchlaufanlagen
Die einzigartige vPlate®-Anlage bietet einzigartige technische Merkmale wie ein automatisches Schmiersystem und den automatischen Jig-Tester, um die beste Ergebnisse zu gewährleisten. Zusammen mit unseren InPro®- und Cuprapulse®-Prozessen deckt diese Kombination von Chemie und Anlage alle relevanten Anwendungen von MLB, HDI, ICS und Starrflex in Panel- und Pattern-Plating ab.
- Cuprapulse® IN – Erste Wahl für die konforme Beschichtung von HAR-Platinen mit der besten Streuung mittels Pulse Plating und unlöslichen Anoden.
- InPro® SAP3 – Einschlußfreies Füllen von Sacklochbohrungen bei minimaler Kupferschichtdicke für ICS-Anwendungen.
- InPro THF2 – Eignet sich nicht nur für zuverlässiges Verfüllen von Durchgangsbohrungen, sondern bietet auch ein hervorragendes BMV-Füllverhalten, hohe Oberflächenverteilung und erhöhte Duktilität speziell für den (a)mSAP-Herstellungsprozeß.
- InPro® VLF – Wenn Sie nach besserer Oberflächenverteilung, höherer Stromdichte, höherem Durchsatz und geringerer Wartung bei der konformen Beschichtung suchen, ist InPro® VLF die richtige Wahl.
MultiPlate® P
Die Lösung von Atotech für die Packaging-Technologien der nächsten Generation
- MultiPlate® ist das ECD-System, das die Vielseitigkeit und Multifunktionalität bietet, die notwendig ist, um aktuelle und zukünftige Herausforderungen für eine optimale Performance hochentwickelter Packaging-Technologien zu bewältigen. Das MultiPlate® P-System ist für Panel-Level-Packaging konzipiert und kann Panels bis zu einer Größe von 650 × 610 mm verarbeiten.
- Innolyte® PLP – Der RDL- und Via-Filling-Prozess bietet eine sehr gute Oberflächenverteilung und Via-Filling-Performance und zugleich rechteckig abgeschiedene Leiterbahnen.
- Innolyte® P – Für Copper-Pillar-Plating für eine hochreine Abscheidung bei Stromdichten von bis zu 20 A/dm² ohne Einschlüsse in IMC und bester Gleichmäßigkeit.
“We offer cost-efficient solutions to the PCB and FOPLP industry with the full spectrum of applications for electrolytic plating of Cu, Sn, Ni, Pd, Au and suitable pre-treatments. Our portfolio comprises of processes for all types of equipment from horizontal to VCP and hoist type systems.“
Bert Reents
Global Product Director Electrolytic Plating at Atotech Germany

Aktuelle Veröffentlichungen
Das Füllen von Sackloch- und Durchgangsbohrungen mit galvanisch Kupfer-Prozessen – Aktueller Stand und Ausblick
2019, PDF, 540 KB
Vergrößerung des Fertigungsformats für die Verkupferung bei FOPLP (Fan Out Panel Level Packaging) zur Senkung der Herstellungskosten
Dieser Artikel wurde ursprünglich auf der IMAPS 2018 in Pasadena veröffentlicht.
2018, PDF, 900 KB
Steigerung der Produktivität bei der Herstellung von IC-Substraten durch die Verwendung eines neuartigen Kupferelektrolyten für die Semi Additive Plating
Dieser Artikel wurde ursprünglich auf der EPTC 2018 in Singapur veröffentlicht.
2018, PDF, 320 KB
Fine-Line-TH-Copper Filling in VCP-Anlagen für die nächste Packaging-Generation
Dieser Artikel wurde ursprünglich auf der SMTA 2017 in Chicago veröffentlicht.
2017, PDF, 510 KB